Product Details
ASML Twinscan XT 1250 D ArF Scanner
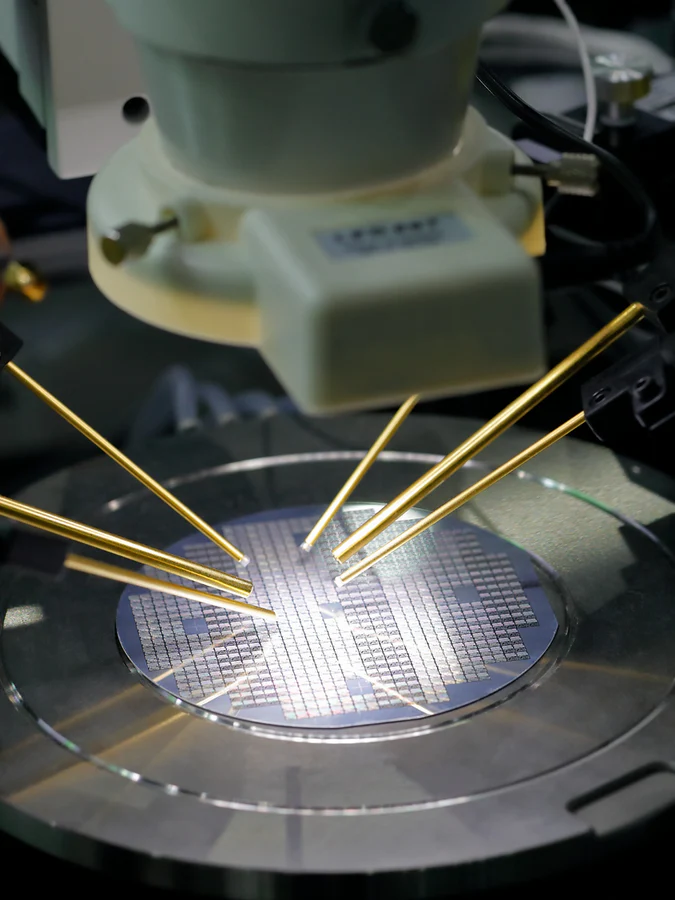
 English
English Chinese (Traditional)
Chinese (Traditional) French
French German
German Japanese
Japanese Korean
Korean












